
芯片底部填充胶的应用探讨
芯片底部填充胶主要用于CSP/BGA等倒装芯片的加固,提高电子产品的机械性能和可靠性。 根据芯片组装的要求,讨论了底部填充在使用中的工艺要求和缺陷分析方法。
倒装芯片键合技术是目前半导体封装的主流技术。 倒装芯片连接引线较短,焊点直接焊接在印刷电路板或其他基板上。 引线电感小,信号间干扰小,信号传输延迟短,电气性能好。 一种互连方法。 这些优势使得倒装芯片在便携设备轻薄小巧的要求下得到快速发展。 图1显示了手机、平板电脑、电子书等便携设备中常用的BGA/CSP芯片结构。 BGA/CSP的芯片引脚位于元件底部,排列成球栅矩阵,通过底部焊点与电路板连接。
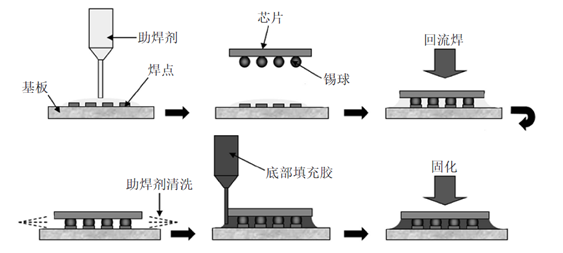
便携式设备中的电路板通常较薄,硬度低,容易变形,细间距焊点强度低,因此芯片的抗机械和抗热震性较差。 为了满足可靠性要求,倒装芯片一般采用底部填充技术对芯片与电路板之间的缝隙进行底部填充。 底部填充材料在毛细作用下,使流动的底部填充材料完全填充芯片和基板之间的间隙。 由于底部填充的芯片在跌落测试和热冲击测试中具有出色的性能,因此在具有小焊球直径和细间距焊点的 BGA/CSP 芯片组装中需要底部加固。
在电路板组装生产中,芯片底部填充胶具有操作方便、流动快、固化快的要求,同时还必须满足填充性、兼容性和可修复性的要求。





